磁控溅射和离子束辅助相结合的系统技术是许多高性能薄膜制程的理想工艺,可以使用在高端镀膜和半导体制程等多个环节。
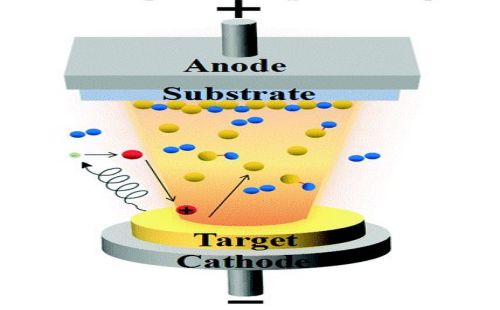
工艺原理:
磁控溅射是一种最基本的气相沉积(PVD)工艺,是一种气态等离子体的沉积技术,该生成的气态等离子体被磁场限制在沉积材料靶的空间内。靶的表面被等离子体中的高能离子侵蚀,释放出的原子穿过真空环境并沉积在基板上形成薄膜。
离子束辅助沉积是在溅射沉积过程中,辅助离子源照射在基板上形成电场用于提高成膜速率,改善成膜的物理密度和机械性能。
制备功能:
为了提高溅射镀膜工艺水平,我们在系统中设计了离子束辅助沉积的磁控溅射工艺系统,该工艺在常用磁控溅射的系统中增加了离子束辅助沉积工艺,使溅射到基片的膜层的致密性更好,成膜速度更快,是表面要求超硬成膜的理想工艺。
设备可选配单/多靶磁控溅射加离子束辅助组合沉积工艺,系统适用于多种金属和绝缘材料成膜工艺。
配备具有磁控溅射和离子束辅助系统,溅射速率比传统工艺更高,溅射靶满足特殊材料沉积要求。
设计基板平行暴露在溅射源有效范围,同时兼具辅助离子源照射角度,基板支架为多边行星旋转功能。
多段式石英灯加热器装置,快速使腔室和基片加热到工艺温度(最高到300°C)。
系统配备实时沉积速率控制单元,运用石英晶体测厚仪将测得的沉积速率调整电源反馈控制单元,控制溅射电流以调节成膜速率。
可选配直流脉源冲或RF电源为磁控溅射电源,更广泛适应各种金属和绝缘材料溅射成膜,包括氧化物、氮化物等材料的成膜工艺。(见附件:PVD沉积材料表)
选配离子源辅助系统,在沉积金属氧化物或氮化物膜时,该系统非常有助于改善膜的物理密度、光学和机械性能,更适合各类超硬镀膜系统。还可以用于镀膜前清洗和蚀刻基板提高附
着力。

工艺特点:
磁控溅射沉积不需要熔化和蒸发原材料,这导致了比其他PVD技术更多的优势:
几乎所有材料都可以通过磁控溅射沉积,而不论其熔化温度如何;
可以根据基板和膜层的要求缩放靶头并将其放置在腔室中的任何位置。
可以沉积合金和化合物的薄膜,同时保持与原始材料一致的物理结构。
利用辅助离子源提供辅助沉积能量,在通过金属靶的反应溅射来沉积氧化物或氮化物膜时,非常有助于改善膜的物理密度。

工艺优点:
离子束辅助的磁控溅射工艺的优势是利用磁控溅射的高能特性和沉积不需要熔化和蒸发原材料的成膜特性,用离子辅助的能量加大溅射到基材表面的原子迁移率,提高成膜速度和密度,改善溅射成膜表面的附着力,是大面积快速成膜的最佳选择。多种超硬AR膜层可快速沉积厚度达到10um以上。
科研设备丨半导体材料丨高精度检测丨清洁度检测丨激光刻蚀丨光栅刻蚀丨离子刻蚀丨等离子清洗丨半导体检验丨蔡司电镜丨材料科研丨二维刻蚀丨倾角刻蚀丨3维超景深丨扫描电镜丨失效分析丨共聚焦显微镜 XML地图